服务热线
021-55050770

在全球“双碳”政策与能源成本上涨的双重压力下,提高功率变换效率、减小体积重量、延长寿命成为功率半导体最迫切的三大诉求。富士电机自1988年发布第一代IGBT以来,保持每五年一次重大迭代。2021年推出的第7代“X系列”首次将连续结温Tvjop从行业普遍的150 °C提升到175 °C,同时在同封装内把电流密度提高约60%,为新一代数据中心电源、储能PCS、电动汽车充电桩及伺服驱动提供了“高功率密度、高温运行、高可靠性”的旗舰平台。
X系列IGBT技术路线
“芯片损耗↓ + 热阻↓ + 耐温↑ + 集成度↑”四条主线:
芯片层面:薄片+精细沟槽+优化场截止(FS)层,实现导通与开关损耗同步下降;
封装层面:高导热氮化铝(AlN)基板、高耐热硅凝胶、高强度焊料及铝线直径/长度协同优化,保证175 °C长期可靠;
系统层面:通过“损耗降低”与“散热增强”双轮驱动,把单封装电流能力推升50%,并维持体积不变或更小;
产品层面:推出标准IGBT/FWD分立芯片与RC-IGBT单片集成两条并行家族,覆盖50 A–2400 A、650 V–1200 V全功率段。
芯片技术创新
厚度减薄约15%,导通压降Vce(sat)下降0.25V(150 °C,100A条件下),换算到20kHz逆变工况,导通损耗降低8%–10%。薄片带来关断尾巴电流缩短,Eoff较6代V系列下降10%,且dv/dt可控,EMI余量>3 dBμV。沟槽节距缩小至亚微米级,表面载流子浓度提升,注入增强(IE)效应显著,进一步拉低Vce(sat)。新FS层在1200V等级可屏蔽薄片化带来的击穿电压下降,并抑制关断电压过冲;高温漏电流降低28%,为175 °C连续运行提供安全裕量。二极管同步采用薄片方案,正向压降VF降低0.15V;通过背面掺杂梯度优化,实现软恢复,反向恢复能量Err下降30%,di/dt下降约20%,显著降低对驱动板与共模滤波器的要求。
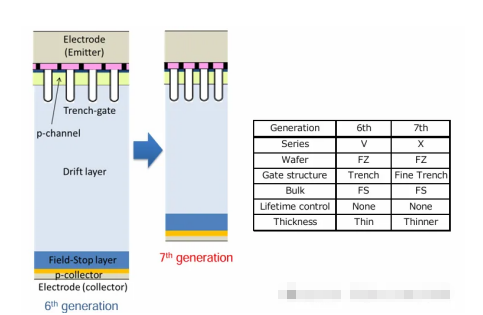
封装技术突破
X系列的高导热AlN绝缘基板热导率≈170W/(m·K),为Al2O3的4–5倍;厚度从0.63mm降至0.38mm,热阻Rth(j-c)下降45%,芯片温升同步下降9–12 °C。通过调节烧结助剂,保持击穿电压>6kV(AC 1min),满足加强绝缘需求。X系列采用175 °C级高耐热硅凝胶,其在传统聚二甲基硅氧烷中引入苯基/乙烯基共聚链段,玻璃化温度Tg提升至220 °C;经215 °C、2000h高温存储无裂纹,绝缘强度保持>25kV/mm,寿命是常规胶的5倍。焊料方面采用Sn-Sb-Ag系高熔点焊料,液相线>250 °C,抗蠕变强度提升60%;铝线直径由300μm加粗至380μm,并采用“短拱+低环”焊线轨迹,降低ΔTvj=50 °C工况下的线脚应力,功率循环寿命达>60k cycles,是V系列的2倍。
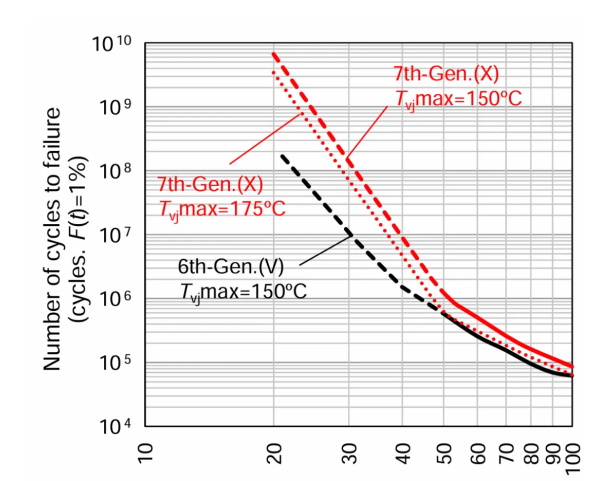
RC-IGBT:单片集成再进阶
富士在X系列平台同步推出RC-IGBT,把IGBT与FWD做进同一芯片,实现了芯片面积共享,有效导电区增加15%,热阻Rth(j-c)再降约20%。单片内交替发热,减小热波动,低频(<5Hz)电机驱动工况下ΔTvj由41°C降至21°C,功率循环寿命提升>2.5倍。封装尺寸大幅压缩:1200V/1000A等级首次在DualXT(150mm×62mm)内实现,比传统PrimePACK™2面积节省39%,满足紧凑型储能变流器与重卡电驱需求。
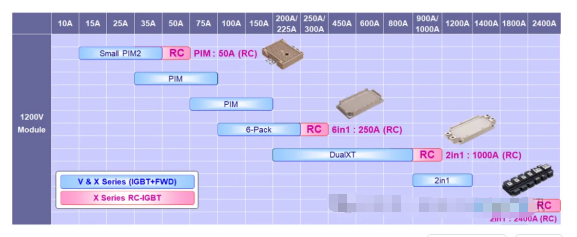
应用设计要点
最大结温与寿命平衡
Tvjop≤175 °C,但随温度升高,功率循环寿命呈指数下降。推荐:
长期运行点≤165 °C,留10°C裕量;
采用NTC或外部温度传感器,实现75%负载以上主动降额。
过压抑制与RBSOA
快速关断时峰值VCEP需<RBSOA边界;建议主回路杂散电感Ls<50 nH,优先使用层叠母排+吸收薄膜电容;
栅极电阻RG并非越大越好,X系列载流子注入效率高,RG过大反而拖长关断尾巴,导致VCEP升高;需按图2-7曲线在25 °C、150 °C双温度点校核。
并联均流
X系列Vce(sat)温度系数为正,利于自均衡;模块间ΔVce(sat)应≤0.3 V,对应电流不平衡<10%;
栅极驱动线、发射极反馈线保持对称布局,使用同一PWM信号源,避免门极振荡。
机械安装与散热
扭矩按MS=1.3N·m(M5)或1.8N·m(M6)执行,采用含65μm厚TIM的相变垫片,可把接触热阻再降10%–15%;
基板铜层表面镀Ni-P,盐雾试验>96h,适合高湿、沿海储能集装箱场景。
产品族谱与路线图
X系列已形成“标准IGBT+PIM+IPM”与“RC-IGBT+PIM+六合一”两大子家族,覆盖650V/50A–2400A、1200V/50A–2400A。2024–2025年富士发布1700V等级及SiN基板版本,单封装电流密度有望再提升20%,并集成温度/电流传感器,向“智能功率模块”演进。
富士第7代X系列IGBT模块通过“薄片沟槽芯片+高导热AlN封装+175 °C高温保障”三位一体创新,成功把单封装电流能力、耐温等级与功率循环寿命同步提升一个台阶,为工业4.0、数据中心UPS、储能PCS及电动汽车快充等高效高功率密度应用提供了立即可用的升级路径。RC-IGBT的推出更进一步打破“芯片-封装-系统”边界,使功率变换在相同散热条件下“更大功率、更小体积、更高可靠”成为可能。随着1700V、SiN基板及智能传感版本的陆续落地,X系列平台有望在未来五年内继续引领行业向“高温、高密、高智”方向发展,并助力全球碳中和目标早日实现。